Страница: 8/18
микроанализа поверхности, т.е. исследования областей диаметром <3 мкм, методами ионного зонда или масс-спектрального микроскопа минимально детектируемый уровень сигнала выше уровня, при котором становится важным перекрывание пиков молекулярных ионов (фиг. 10); следовательно, если требуется осуществить только общий анализ малых участков твердого тела, то высокое разрешение по массам не обязательно. Если же интересоваться следами элементов в сложных матрицах, то необходимо иметь масс-анализатор с высоким разрешением по массам.
Анализ следов элементов
Предполагаемый порог чувствительности метода ВИМС для многих элементов близок к 10-9. Но для обеспечения общего порога чувствительности такого порядка на практике необходимо использовать (как видно из сказанного выше) масс-апализаторы с высоким разрешением и высокой чувствительностью к относительному содержанию и, кроме того, контролировать ряд эффектов, о которых говорится ниже.
Большая часть вторичных ионов выходит из нескольких наружных атомных слоев твердого тела, а поэтому вещество, адсорбированное на поверхности, выступает в спектре как важный компонент твердого тела или его поверхности. Среда, окружающая образец, обычно содержит молекулы углеводородов, Н2, N2, О2, Н2О, СО2 и СО. Поэтому обнаружение в матрице следов таких элементов, как С, N, Н и О, оказывается весьма сложным в том случае, если не приняты специальные меры для сведения к минимуму их влияния. Меры эти таковы: проведение измерений в сверхвысоком вакууме, свободном от углеводородов, применение криогенной и геттерной откачки объема вблизи образца и работа при высоких плотностях тока первичных ионов, при которых скорость удаления поверхностных слоев в результате распыления намного больше скорости поступления частиц загрязнений. При давлении 10-8 мм рт. ст. скорость прихода на мишень атомов или молекул остаточных газов приблизительно равна скорости поступления ионов первичного пучка с плотностью тока - 10 мА/см2.
Источниками загрязнений служат также поверхности , расположенные вблизи мишени, на которые попадает значительное количество распыленного вещества. Часть этого вещества в результате испарения или распыленная вторичными и отраженными ионами может возвращаться на мишень. Это так называемый “эффект памяти”, и его значение в конкретном анализе зависит от предыстории образца. Данный эффект наиболее значителен в приборах, где используются большие токи первичных ионов, а вытягивающие линзы расположены вблизи поверхности изучаемого образца.
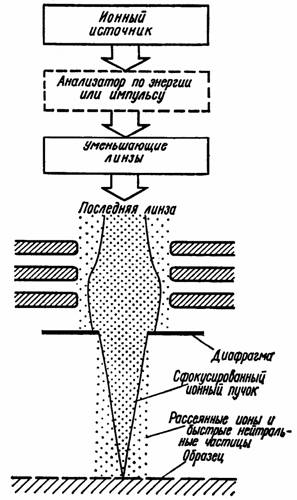
Фиг.11. Компоненты сфокусированного ионного пучка, связанные с рассеянными ионами и нейтральными атомами[1].
Чтобы предупредить внедрение в образец того элемента, содержание которого определяется, особенно важна химическая чистота первичного ионного пучка. При типичных условиях (скорость распыления образца, пробел и разброс по пробегам первичных ионов) и в предположении, что распыление продолжается достаточно, долго, для того чтобы воздействовать на уже легированную зону, а основным источником ионов примеси является обратное распыление ранее внедренных частиц, присутствие в первичном ионном пучке 10-6 загрязнений должно проявиться как объемная примесь с атомной концентрацией ~10-7. Чтобы гарантировать чистоту первичного ионного пучка и исключить возможность осложнений на уровне следов элементов, желательно осуществлять сепарацию пучка первичных ионов по массе.
Чтобы уменьшить влияние загрязнения поверхности остаточными газами, при анализе объемного состава твердого тела обычно пользуются первичными ионными пучками с высокой плотностью тока. При этом область
Реферат опубликован: 22/03/2008