Страница: 5/18
Принцип действия установок.
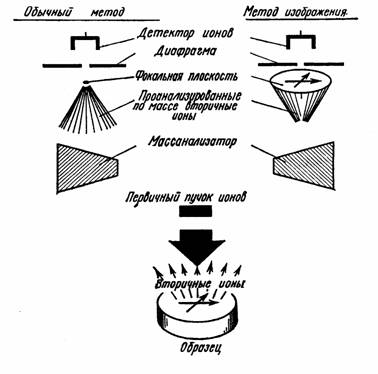
Фиг.6. Схема обычного метода и метода прямого изображения при
масс- спектрометрическом анализе вторичных ионов[1].
При масс-анализе вторичных ионов применяются два основных метода: обычный масс-спектрометрический и метод прямого изображения. Они схематически сопоставлены на фиг.6. При первом методе анализатор с хорошим разрешением передает на высокочувствительный ионный детектор заметную часть быстрых вторичных ионов, идущих с большой площади образца (» 1 мм2). Выделенные по массе вторичные частицы собираются в точечный фокус на входной щели детектора. В этом статическом случае получаемая информация усредняется по поверхности образца и невозможно установить, из какой точки (например области диаметром 1 мкм) поверхности приходят вторичные ионы. При методе прямого изображения в фокальной плоскости анализатора создается стигматическое ионное изображение поверхности и путем соответствующего дифрагмирования (или преобразования изображения при помощи чувствительной к электронам или ионам эмульсии) легко можно получить информацию о точках выхода ионов с данными m/e с поверхности образца.
Все установки с прямым изображением основан на идее прибора Кастэна и Слодзяна; все иные приборы представляют собой варианты обычной масс-спектрометрической методики. Для получения вторично-ионного изображения поверхности при обычном подходе необходимо проводить последовательный анализ вторичных частиц при сканировании поверхности
мишени первичным ионным пучком малого диаметра. При этом для получения изображения мишени на экране электронно-лучевой трубки (ЭЛТ) проще электрически сканировать первичный пучок, нежели механически перемещать сам образец. Электронный луч в ЭЛТ синхронизирован с первичным ионным пучком, и усиленным сигналом вторично-ионного детектора модулируются интенсивность электронного луча в ЭЛТ. Получаемое при таком методе увеличение изображения равно отношению длины строки на экране ЭЛТ к расстоянию на поверхности образца, пробегаемому первичным ионным пучком в процессе сканирования.
Все установки ВИМС позволяют осуществлять анализ поверхности и распределения концентрации элемента по глубине. Они различаются в таких важных отношениях, как порог чувствительности при детектировании, разрешение по массам, плотности тока первичного пучка, вакуумные условия в окрестности мишени, а также возможность проведения анализа распределения элементов по поверхности, или топографического (x-y) анализа, путем сканирования зондом или формирования изображения. К устройствам для топографического анализа относят лишь те, которые позволяют получить разрешение по поверхности не хуже 10 мкм. Все существующие установки ВИМС можно разделить на три группы в соответствии с принципом их устройства и пригодностью для микроанализа:
· не позволяющие осуществлять анализ распределения элементов по поверхности;
· дающие сведения о распределении по поверхности с помощью сканирующего ионного зонда;
· дающие сведения о распределении по поверхности методом прямого изображения.
Установки, не обеспечивающие анализа распределения частиц по поверхности
Ряд вторично-ионных масс-спектрометров был сконструирован для решения частных аналитических проблем или исследования различных закономерностей вторичной ионной эмиссии.
Использованные на ранней стадии исследований этого явления анализаторы с однократной фокусировкой (секторные магниты) имели весьма ограниченное разрешение по массам и низкую чувствительность, что было обусловлено большим разбросом начальных энергий вторичных ионов.
В настоящее время большое внимание уделяется квадрупольным анализаторам, поскольку они, будучи просты и недороги, позволяют получать сведения о поверхности и профиле концентрации примеси почти во всех случаях, когда не требуется информации о распределении по поверхности или очень малых количествах примеси. Добиться снижения фона при работе с квадрупольным фильтром масс можно за счет предварительной селекции вторичных ионов плоскопараллельным электростатическим анализатором с малой диафрагмой, а также внеаксиального расположения ионного детектора.
Реферат опубликован: 8/12/2006